据Yole数据统计,系统级封装(System-in-Package,SiP)市场总收入在2022年达到212亿美元。在5G、人工智能(AI)、高性能计算(HPC)、自动驾驶和物联网(IoT)等细分市场中异构集成、小芯片(Chiplet)、封装面积和成本优化趋势的推动下,预计2028年该市场总收入将达到338亿美元,年复合增长率(CAGR)为8.1%。细分市场来看,移动和消费主导SiP市场,占2022年总收入的89%,且未来将继续主导市场,年复合增长率为6.5%。
驱动该细分市场的动力包括:2.5D/3D技术在手机、高端PC和游戏领域的日益普及,高端手机设备的高清FO,以及手机和可穿戴设备中更多的FC/WB SiP。电信和基础设施市场预计将在未来几年增长20.2%,驱动力包括AI、HPC和网络领域不断提高的性能要求。汽车市场正在以15.3%的年复合增长率增长,驱动力包括汽车电气化和自动驾驶趋势,也包括ADAS和LiDAR等应用,这些应用需求更多数量的传感器和摄像头。
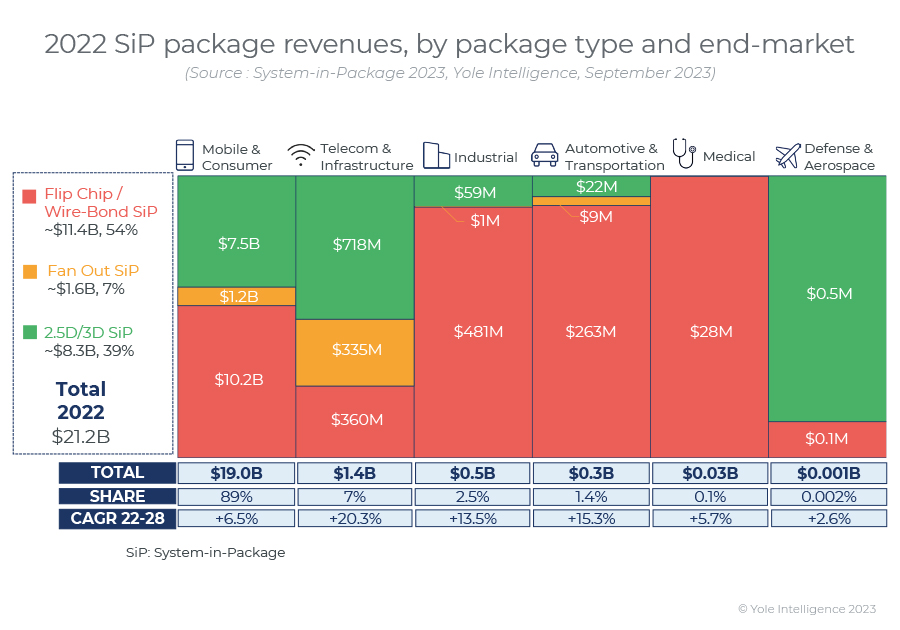
Yole表示,SiP市场份额由亚洲主导,占收入的77%。日本占据最多(41%),主要得益于索尼的3D CIS市场。北美地区由 Amkor 和 Intel 贡献,占收入的21%。欧洲占据剩余市场的2%。对于FC/WB SiP,主要由OSAT提供,包括 ASE(与SPIL)、Amkor、JCET、TFME、PTI、Huatian、ShunSin 和 Inari;FO SiP 由台积电 (TSMC) 及其 InFO系列主导。2.5D/3D SiP主要由索尼的CIS市场主导,其次是台积电的硅中介层、硅桥和3D SoC堆叠。在Chiplet、异构集成、成本优化和占地面积减少趋势的推动下,SiP吸引了更多参与者进入供应链市场。芯片和内存厂商、无晶圆厂以及代工厂/内存厂商之间正在观察更多的合作模式,以引入HBM3、人工智能产品、小芯片技术和混合键合等领先技术。中国SiP的足迹正在扩大,OSAT和IC载板业务与世界其他地区的兼容性越来越强。他们的 OSAT/EMS/代工业务模式在 SiP 市场上受到关注。中国企业的目标是开发封装技术来解决小芯片和混合键合活动,以实现扩展要求并能够提供有竞争力的产品。

随着行业不断要求更高的集成度以实现更小外形尺寸和更高性能的产品,SiP技术趋势依然强劲。在移动和消费市场,由于空间有限,因此非常需要占地面积优化——这对于智能手机、可穿戴设备和其他设备来说是有效的。例如,5G在高端智能手机中的渗透推动了射频和连接模块采用SiP,需要集成更多组件并缩短互连才能实现所需的性能。
随着人工智能和高性能计算的兴起,Chiplet和异构集成解决方案受到越来越多的关注。这推动了更复杂的先进SiP解决方案的采用,尤其是UHD FO和2.5D/3D封装,以满足更高的密度、更低的带宽和更高的性能要求。由于需要更小的L/S、高密度FO RDL以及桥接器、中介层和3D堆叠等2.5D/3D技术,并通过混合键合将更多组件集成到SiP封装中,因此该路线图仍然具有挑战性。