韩媒Etnews报道,三星为了追上台积电先进封装人工智能 (AI) 芯片,将推出FO-PLP的2.5D先进封装技术吸引客户。三星DS部门先进封装( AVP) 团队开始研发将FO-PLP先进封装用于2.5D芯片封装,可将SoC和HBM集成到硅中介层,构建成完整芯片。
2.5D封装是近年人工智能芯片不可或缺的制程。以全球供不应求的英伟达 (NVIDIA) 人工智能芯片来说,就是采2.5D封装技术集成,但由台积电CoWoS 2.5D先进封装拿下订单。
与台积电CoWoS 2.5D不同的是,三星FO-PLP 2.5D是在方形基板封装,台积电CoWoS 2.5D是圆形基板,三星FO-PLP 2.5D不会有边缘基板损耗问题,有较高生产率,但因要将芯片由芯片移植到方形基板,作业程序较复杂。
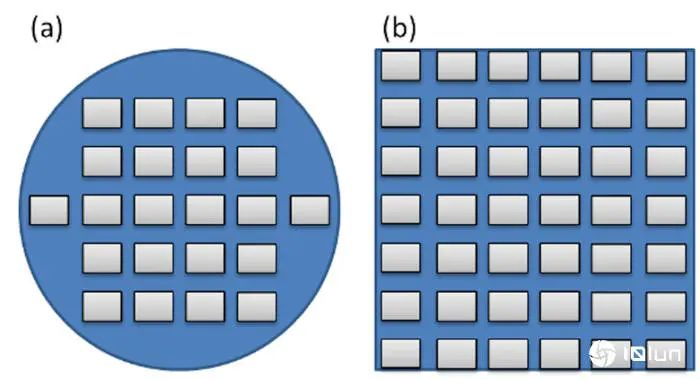
三星战略是利用FO-PLP 2.5D追上台积电,因三星DS部门2019年从三星电机收购FO-PLP后就开始研究智能手表和智能手机处理器商业化,并扩大FO-PLP使用。目前已用于功率半导体封装。
报引导用韩国市场人士说法,从国际学术会议三星连续发布FO-PLP论文看,三星致力开发FO-PLP,以克服2.5D封装局限性。若FO-PLP成功,就能与芯片代工和内存业务互相拉高,故三星提出一站式方案 (Turn-key) 吸引客户,为AI设计厂商(如NVIDIA和AMD)生产半导体、加上HBM和先进封装。先进封装若更有竞争力,三星就能更壮大半导体业务。




