据未来半导体统计,2023 Q2 是ABF载板景气最差的一季。但下半年ABF载板厂的营收将逐步重回成长轨道。2023全年ABF载板需求将达3.45亿片。ABF供应商均认为,Chiplet、先进封装、AI与伺服器等发展都会驱动ABF载板产能扩张。2023~2025年ABF载板市场将规模增长。在2021-2023投入拓展的厂商将在复苏期重新瓜分ABF市场。但整体而言,到2025年之前ABF载板仍处于供不应求的状态。
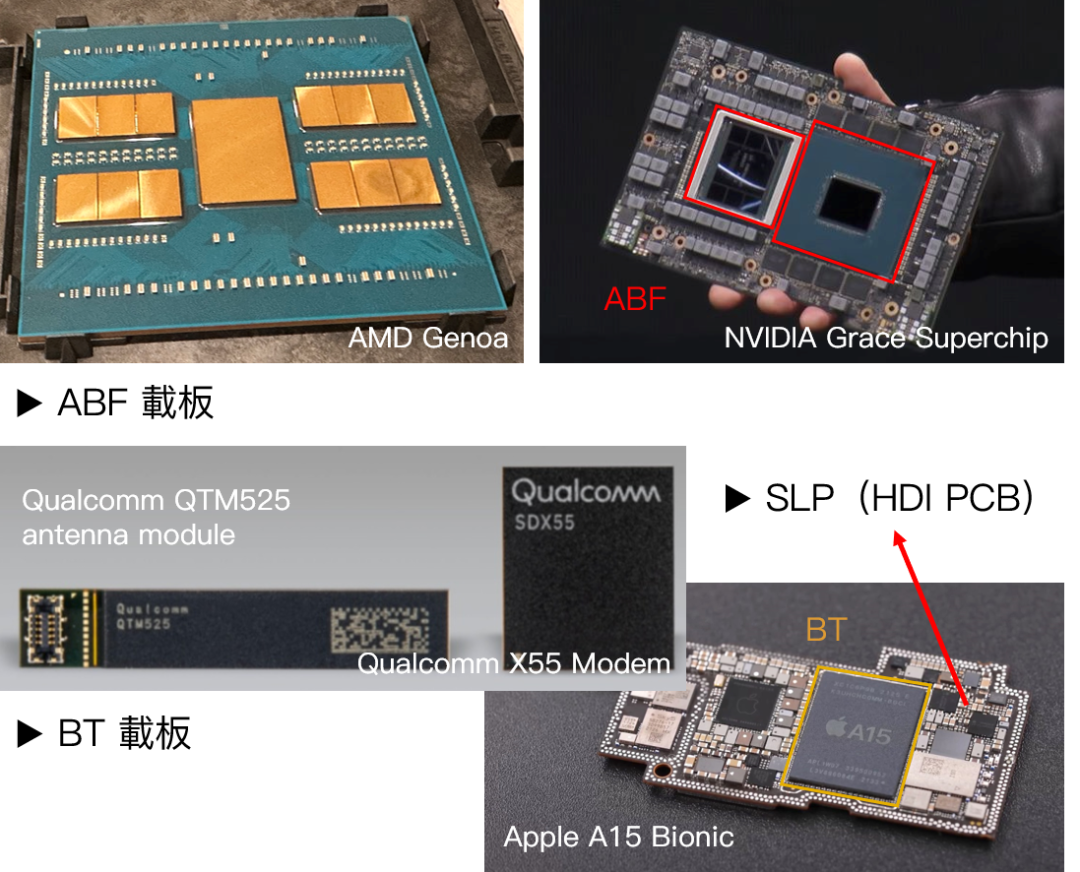
图源:cnBeta、AnandTech、Qualcomm、iphoneislam
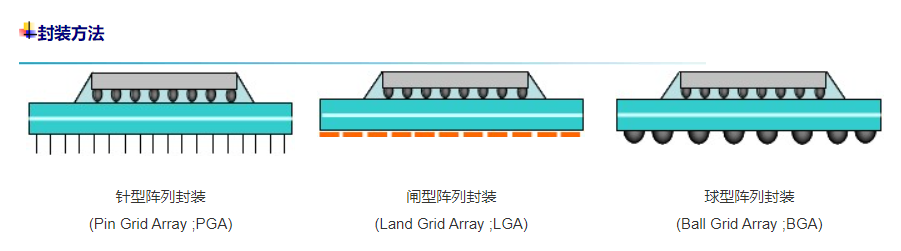
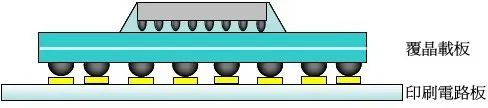
图源:南亚电路
ABF,(Ajinomoto Build-up Film,味之素堆积膜),名字来源于一家生产绝缘材料的日本公司味之素,由英特尔在20世纪90年代末推出,使其开发了更强大的微处理器。ABF基板由环氧树脂/苯酚硬化剂、氰酸酯/环氧树脂和带有热固性烯烃的氰酸酯制成,其特性伴随趋势需求精进:
ABF载板引脚数量多,传输速率高、线路较精密、导电性好、不需要热压过程,适合高脚数高传输IC,广泛应用于5G、AI、云计算、大数据分析等领域的高性能计算芯片的FC封装; 从封装材料成本来看,高端倒装IC载板的成本占比高达70%~80%,成为先进封装工艺价值最高的材料,ABF载板成为FC-BGA封装的标准配置; 随着高性能运算性能快速提升,这就要求不断研发具有不同性能的ABF绝缘树脂,改进产品特性以满足新兴客户要求的加工技术以及反复进行测试和验证; 智能手机功能复杂化和5G高频通信传输要求, ABF绝缘材料的热稳定、散热和低介电等特性将更为重要,目前ABF材料易受热胀冷缩影响,可靠性较低。
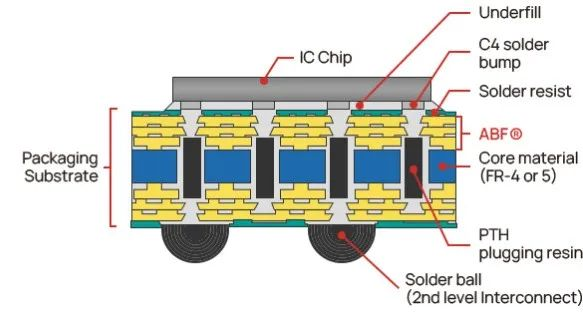 图源:Ajinomoto
图源:Ajinomoto
触底反弹开辟更强的应用市场
随着半导体生产工艺逼近物理极限,芯片向SoC方向发展加速异构集成技术趋向成熟, ABF已经发展成为高端IC载板主要的增层材料。高性能计算成为近年驱动ABF载板市场成长的主要因素。先进封装技术推升对ABF载板产能的消耗,导入2.5/3DIC高端技术的产品,未来有机会进入量产阶段,势必带来更大的成长动能。
以FC-BGA为主流的先进封装技术显著提升高阶芯片效能,对所需的ABF载板更加复杂化。从面积、层数与制作难度上,台积电的CoWoS技术、Intel的EMIB技术都消耗了大量高阶ABF产能;
HPC/AI 服务器作为高性能计算平台,芯片组采用异构平台方案, ABF 载板面积显著增加。以一台1800亿参数的GPT-3.5大型模型,需要的GPU晶片数量高达二万颗,未来GPT大模型商业化所需的GPU晶片数量甚至会超过三万颗,每一颗晶片都需要搭载ABF载板,需求量未来成长可期。

2023年苹果已经开始规划第二代AR/MR头戴装置配备双CPU,并且双CPU都将使用ABF载板。将于2024年下半年出货。据预测,2023/2024/2025年,苹果AR/MR装备出货量分别有望达300万部、800-1000万部与1500–2000万部,对应ABF载板需求600万片/1600-2000万片/3000-4000万片。
ABF载板并未因产业周期下行而减少投资扩产。韩国、日本和中国大陆及台湾的ABF载板商正积极拓建工厂、提升产能。目前,在行业触底之际,高性能运算、新能源电动车、5G、AI、IoT 等新兴应用将助推ABF反弹。英特尔、AMD、Nvidia 等主要半导体公司都依赖更多 ABF 基板来生产芯片,正积极与全球ABF载板制造商签订至2023-2025年的长期合同,以避免ABF供应不足对下一代芯片产品的推出造成影响。
这也导致ABF载板价格飙升了30%-50%。花旗集团分析师预测,到2024年,供应预计将以16%的复合年增长率增长,而需求预计将增长18%至19%。
▽
ABF载板全球竞争格局,日本最具竞争力
ABF载板项目技术难度高、投资周期长、行业进入壁垒高、竞争格局相对固化。
传统BT载板在2-4层,无法满足高阶运算的层数需求。当前,ABF载板主流层数将由10层提升至12-14 层。就技术层次来说,欣兴可做到32层,景硕14层、南电8-16层,大陆企业越亚半导体可实现14-20层以上的产品突破。(可反馈)
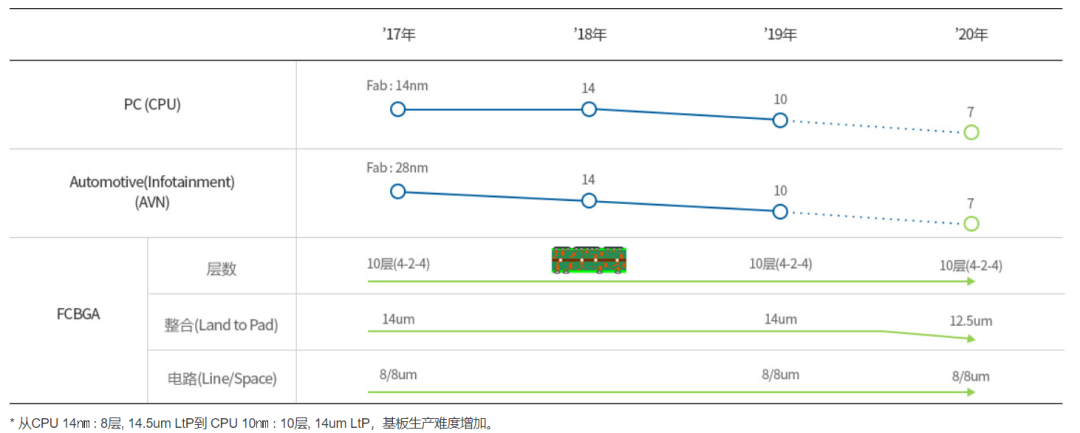 图源:三星电机
图源:三星电机
另外,从线路细密度上,BT载板线路在12 微米以上,ABF线路细密度进入6-7微米,在2025年正式进入5微米的竞争;常规BT载板尺寸基本是几毫米,AB 载板常见的有35mmX35mm、100mmx100mm甚至200X200mm 的整合性芯片,多用于AI与高性能运算。中国大陆有深南、越亚、兴森、华进等具备小批量生产线宽/线距12/12-15/15μm FCBGA封装基板的能力(可反馈),离全球大厂仍有差距。
全球IC载板供给市场上,ABF载板主要被中国台湾、日本、韩国厂商垄断。据台湾工研院产科所的数据显示,2022年全球前十大载板厂高度集中,占了全球84.8%的产值。具体来看,前五大载板厂分别为欣兴(17.7%)、南电(10.3%)、日厂Ibiden(9.7%)、韩厂SEMCO(9.1%)、日厂Shinko(8.5%),五家载板厂合计占一半以上的全球份额。据Prismark此前测算,深南电路、安捷利美维、珠海越亚、兴森科技四大内地基板厂商市场占比仅约为6%。中国大陆厂商的市场份额较小,仍以BT载板为主。在ABF载板等高端产品领域,国产化率极低。
近年AI、HPC 快速发展,对FC BGA 需求扩大,日本和中国台湾都在提高其ABF 载板比重,台湾 ABF 载板占整体IC 载板比重约达65%,日本约为70%。中国台湾目前虽在载板产能上较为领先,但日本除了具备量产能力外,在载板材料(ABF、BT)、高阶特化品(干膜、药水、油墨等) 与关键制程设备(曝光机、雷钻机、检测机等) 也居领导地位,因此若从整体产业链来看,日本载板产业最具竞争力。
▽
日本味之素垄断ABF载板核心原材料
随着处理器越来越小,速度越来越快,印刷电路板制造商需要更好的绝缘材料来保持性能,这也是ABF诞生的直接需求,ABF 有助于这些微米级电路的形成。
1996年,味之素决定启动ABF技术项目,在四个月就完成了原型和样品的开发。但直到1998年都依然无法找到市场,团队面临解散的困境。但研发团队么有放弃,仍在改进ABF性能。直到1999年,团队将最新的ABF样品交给一家致力于打造高性能计算的前瞻性半导体厂商,并在这家伯乐公司的带动下,ABF在千禧年后应用于各类半导体芯片制造环节,并被整个半导体行业所接受。
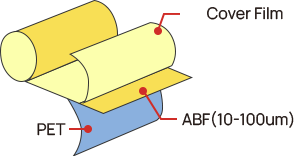
ABF膜有三层结构:支撑介质(PET)、ABF树脂、保护膜 图源:Ajinomoto
味之素团队在苦寻市场的三年时间里,始终坚信仍然ABF膜有市场潜力,构建知识产权保护体系,不断提高技术壁垒。如今,在ABF膜市场,味之素独霸天下,拥有拥有95%以上的市占率。但只此一家难以满足全球供应产能,这也是造成ABF载板短缺的“祸根”。一家日本味精企业,就这样卡住了全球半导体芯片产业的脖子。
随着对用于PC的CPU和用于数据中心的服务器的需求的增加,安全性也在稳步增长。为了进一步扩大业务,于2016年在硅谷成立了味之素精细技术美国公司。ABF用作高性能半导体 (CPU) 的绝缘材料。目前,味之素 ABF膜占据全球主要个人电脑用绝缘膜近100%的市场份额。2022财年,公司约有60%的ABF输出将用于高端数据中心服务器,预计到2030财年这一比例将达到75%至85%。

使用说明:在基板上层压后,通过各种工艺形成布线 图源:Ajinomoto
针对液体树脂涂布过程中出现印刷不规则和气泡导致成品率下降、需要自由控制导体厚度、消除半加成工艺中去除铜箔等步骤等难题,味之素ABF增塑膜可以有效改善这些难题,且拥有竞品比较优势。
与液体涂料相比可以消除液体树脂涂布过程中由于气泡和印刷不规则造成的良率损失; 与树脂涂层铜箔(RCC)比较,有利于形成精细图案、易于蚀刻、易于激光加工; 与光通孔材料相比,有卓越的设计自由度。当堆叠多个绝缘层时,不仅可以在1-2层之间完成通孔加工,还可以在1-3层之间完成通孔加工。

目前ABF膜有四大种类,分为GX-92(标准型)、GX-T31(低表面粗糙度、低CTE)、GZ-41(低表面粗糙度、低CTE、高Tg)、GL-102(低表面粗糙度、低介电损耗角正切、低CTE、高Tg)。
为不得罪天下人,味之素持续执行扩产计划,2022 年已投入10亿日圆,2023 年再投入170 亿日圆,进一步提升ABF膜的产量规划以满足全球友商对先进封装的需求。针对下一代计算,味之素也在研究神经计算、量子计算以及光计算的相关材料。
▽
精准卡位,挑战霸主,“秦膜”上线
面对味之素垄断ABF原材料市场的神话,恐被来自中国的上市企业——天和防务打破。对标IC载板关键的ABF材料,2023年2月,天和防务推出“秦膜”系列高性能介质胶膜,给出了芯片基础材料领域国产化替代解决方案。
2023年6月天和防务在接受机构调研时表示,由天和防务子公司天和嘉膜生产和销售的“秦膜”系列高性能介质胶膜采用领先的无溶剂胶膜制备技术产品可用于生产高性能覆铜板材料,性能可以达到味之素公司生产的ABF膜的对标型号,可用于FC-BGA封装。
据天和防务2022年报资料,在2022年,子公司西安天和嘉膜工业材料有限责任公司面向新的市场机遇,完成了类ABF膜的IC载板增层胶膜的中试和小批量试产,并计划于2023年下半年实现量产。我们期待天和秦膜系列无溶剂介质胶膜在IC封装胶膜领域展现出强大的竞争力。
伊帕思致力于先进半导体封装材料的研究,在BT基板材料和类ABF膜领域积累了丰富研发和生产经验,为IC封装及Mini&Micro LED显示产业提供技术先进的半导体基材及解决方案。公司于2022年9月初在江门鹤山签约完成ABF膜生产基地项目。
华正新材是国内覆铜板领先厂商, 战略引入新品锂电池软包用铝塑膜, 积极研发可用于 FC-BGA 的 CBF 积层绝缘膜,与深圳先进电子材料研究院联合,预计2025年放量,预期营收匹配市场约20亿,净利润3亿以上, 有望加速国产替代进程。
2022年中京电子参股盈骅新材,后者有FC-BGA封装载板用ABF增层膜的研发以及产业化项目,生产的ABF载板增层膜已经向全球ABF载板龙头企业开始送样验证。
▽
全球主要ABF载板厂商持续扩产
日本Ibiden目前是全球ABF载板产值的龙头之一。Ibiden倒装芯片封装基板运用超精细布线的导体图案化技术和具有高连接可靠性的微孔技术提供世界一流的微图案、可靠性和电气特性,广泛用于 PC 和数据中心、半导体MPU、 AI 和车辆的GPU。手握大量英特尔、超威等美系大厂处理器订单,是台湾一哥欣兴多年来最大的竞争对手,
看好AI对载板的需求成长,IBIDEN今年初宣布扩产,要在日本岐阜县新工厂投资二千五百亿日圆,借此提高IC基板等产品的产能,更预计2024年在Gama Plant大幅扩充ABF载板产能,量产后总产能将较2019年提升2.2至2.3倍,主要针对资料中心、伺服器需求。将在2025年扩充产能约40%,以因应英特尔下一代伺服器平台Birch Stream的需求,载板面积将较前一代的Eagle Stream扩大约六到七成,加上AI与先进封装趋势带动,预期ABF产业自明年起又将出现新一波强劲成长力道。
在全球半导体需求不断增长的情况下,日本Shinko将主要扩大面向高性能半导体的FCBGA封装基板的研发生产。SHINKO提供倒装芯片封装基板DLL,该基板通过使用半加成工艺、多层结构而具有精细的线路图案,并通过使用堆叠通孔结构而具有优异的电气特性和设计灵活性。SHINKO 开发了无芯封装 DLL3,该封装具有更薄的厚度结构、良好的电气性能和高设计灵活性。
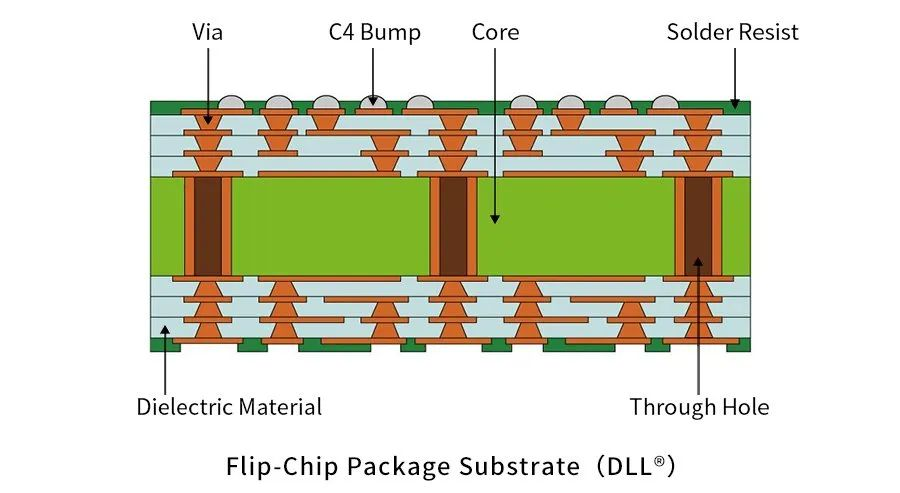 图源:SHINKO
图源:SHINKO
2021年10月,SHINKO计划在千曲市建设新工厂,以扩大倒装芯片型封装的生产能力。2022年宣布在长野县千曲市建设的新工厂将于2024年度下半年启动。2022~2025年的投资额为1400亿日元,通过资本投资的产能预计将比以往增加50%。
三星电子旗下载板厂三星电机是韩国首家开发服务器用FCBGA的厂商。FCBGAB有 Standard Core、Thin Core产品,是提升电、热特性的集成封装基板。
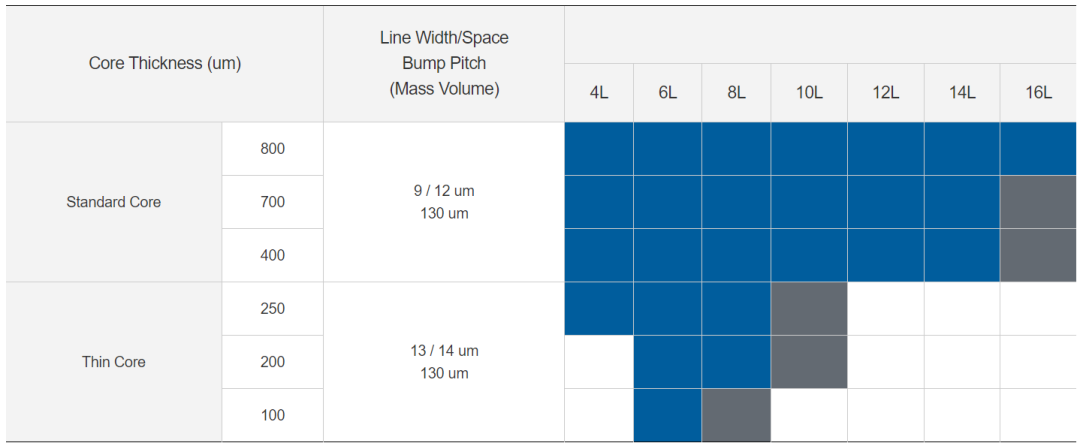
图源:samsungsem
因工业和汽车市场对高阶产品的需求不断成长,2022年3月,三星电机投资约2.47亿美元扩建位于韩国釜山的FC-BGA工厂;总成本为 8.5亿美元越南ABF基板工厂动工改造,将于2023年下半年开始量产。瞄准自驾车市场,三星电机于2023年开发出可用于先进驾驶辅助系统(ADAS)的车用ABF载板。显示出公司力争在该领域获得更大份额的雄心。
AT&S(奥特斯)是欧洲领先的高端印制电路板和半导体封装载板制造商,力争到2025年跻身全球三大ABF载板供货商。其倒装芯片技术,创建一个有覆铜通孔的增强芯,作为构建多层绝缘介质和铜电路的基础。半加层制程(mSAP)技术。这种灵活的方法为行业领先的高密度互连技术实现了性能、可靠性和价值的最优组合。
 重庆工厂 图源:AT&S
重庆工厂 图源:AT&S
AT&S在2021年投资20.7亿美元在东南亚新建ABF基板生产基地,以满足其主要HPC芯片客户的需求。计划于2024年开始量产,并于2026年实现满负荷生产。2021年为重庆ABF载板厂追加2亿欧元。目前,重庆工厂的半导体封装载板生产线扩建项目正在迅速推进中。目前已量产,到2024年初将实现满产。
▽
台湾三雄,扛鼎日韩
台湾的半导体产业除了拥有核心优势的人才、技术外,最重要的是构建了完整的产业供应链,而随着最近年来IC封装逐渐为BGA、CSP,甚至是Flip-Chip所取代,成为封装主流的趋势下,台资载板公司专注在高阶封装载板研发及制造技术上的投注,已成为技术领先的优势,其中包含细线路、薄厚度、复杂结构等技术,结合对市场发展及需求的敏锐触角(如AI),逐渐形成整体领先同业的优势能力。诞生了南亚电路、欣兴电子、景硕科技等在ABF封装基板领域全球最大的几个玩家。
面对2023异军突起的AI浪潮带来高性能运算芯片对ABF的需求,台湾载板三雄也不遑多让,欣兴今年新厂投资达到三百亿元规模,主要锁定准未来高速传输的AI伺服器及载板产品市场大量需求。南电今年支出约一百亿元,启动树林二厂扩产计划,全年将新增22-25%新产能,以争取更多高阶产品订单。景硕今年资本支出达一百亿元,针对ABF扩充三至四成的产能达每月40M的水准,预计今年第三季扩产到位。
欣兴电子是全球IC载板龙头,全球第二大的ABF载板供应商。目前供应包含Intel、AMD 伺服器CPU,以及NVIDIA A100、H100 GPU 所需的ABF载板,相关客户还有Apple、Marvell。相关产品是覆晶载板,具备良好的电性功能,满足各类高/中/低阶晶片需求,产品特色如封装尺寸从8mm x 8mm 至110mm x 110mm、最小线宽与线距能力8/8um、最小凸块跨距90um、阻抗控制以维持讯号完整性、1/2/1 到10/n/10 多层板叠构、符合AEC-Q100 grade 0 可靠度验证、使用于2.5D 与chiplets 封装、使用low Dk/Df材料实现高速传输需求、可提供元件埋入式结构。
覆晶载板 图源:欣兴电子
公司在2023年资本支出估为422亿元,资本支出主要包含昆山厂迁移与新建、光复厂(新厂预计2025年贡献产能)、杨梅厂年底验证完成(产能2023年开出)、苏州厂等产能扩展,资本支出中80~85%将用于高端载板产线扩展。
公司目前有约40%ABF载板为高阶载板,ABF营收占比超47%。受益于缺货,欣兴公司在努力扩张,约60%的扩容支出将用于ABF载板的扩容,到2023年将使该产品的营收占比提升至37%。
 图源:Source:Intel、AMD、NVIDIA、Broadcom、Goldman Sachs、富果研究部
图源:Source:Intel、AMD、NVIDIA、Broadcom、Goldman Sachs、富果研究部
2023下半年产品进行备货,ABF载板产能利用率有望回升,进入2024 年后持续回稳基于客户长期合作并希望保留产能下,预约订单已陆续订到2027年至2030年。主要客户Intel下一代伺服器平台Birch Stream CPU载板面积较前代大增7成,预期相关应用将消耗ABF大量产能。高速运算持续发展将同步带动载板长期需求,欣兴将成为未来趋势主要受惠者。新竹工厂的新ABF载板产能将于2025年投入使用,将专注于生产高端异构芯片集成产品,以满足英特尔高性能计算芯片供应商的需求。
景硕科技致力于成为世界级载板制造及技术领先厂商,已成近年高性能应用结构性需求上升的主要受益者,因为景硕有 35% 以上的 ABF 收入由高阶产品贡献。公司与ABF载板相关的是覆晶球闸阵列封装载板(FCBGA),具备单颗排列、细线路小间距、非常高层数、多种表面处理特性,可应用于微处理器、图像处理器、特化功能IC、现场可程式化闸阵列。
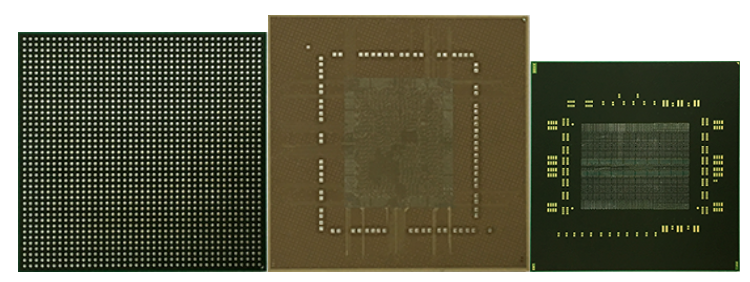 FCBGA 图源:景硕
FCBGA 图源:景硕
景硕目前主要客户是Apple、Nvidia、Broadcom和联发科等,拥有产能2022年扩充ABF产能30%~40%,产能每月达2600万片。景硕2023年资本支出仍为185亿元,持续扩充ABF载板产能至40%,每月达4000万片。景硕ABF载板生产基地以新丰厂为主,清华厂为辅。公司长期看好ABF载板产品随着人工智慧、物联网、高效能运算、机器学习、汽车应用、5G/6G基础建设等需求成长。在中长期布局,景硕中期持续研发微缩线宽、孔径、厚度等基本半导体,长期朝高频材料系统、嵌入主动/被动组件、直接芯片贴合等复杂结构发展技术。
南亚电路是ABF载板的“三哥”。受惠于整个半导体业的高速运算需求,南亚电路2022年ABF产品营收占比近60%,为公司核心业务。主要客户包括博通、辉达、超微半导体、苹果。公司覆晶载板产品介绍与应用包括:针型/闸型阵列封装面向微处理器,球型阵列封装面向绘图晶片、北桥晶片、游戏机晶片、高阶ASIC晶片、数位电视晶片。
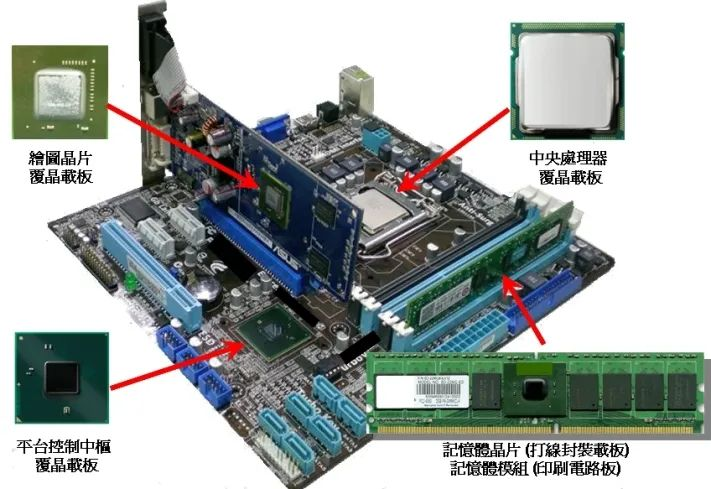
图源:南亚电路
ABF载板作为南亚电路未来高价值产品方向,将与客户紧密合作,持续开发4nm电脑处理器、伺服器处理器、资料中心交换器及5G网通设备应用载板,树林一期、昆山厂二期的ABF新产能于第一季全能生产,并致力于树林厂二期提前量产,并将每个单厂的年产能提升至3600~4800万片。据多家媒体报道,南亚电路板计划在2024年前投资400亿元新台币进行产能扩充,预计载板产能将比2020年增加70%
受到NVIDIA AI急单涌进,台湾载板三雄目前都有来自NVIDIA订单,据了解,欣兴在NVIDIA佔比约28%,景硕约15%,南电约10%,2023年ChatGPT、生成式AI风起云涌,随着资料中心的建置,未来三雄在ABF载板出货可望持续增温。
▽
大陆破零,火速追赶
国内ABF载板占全球份额为25%。目前中国大陆ABF载板主要依赖进口,因国内暂时无高阶量产企业,(可反馈)国内相关封测和芯片设计公司无法得到足够支持。中高端基板采购仍以进口为主,通常面临交期长、服务不到位的问题。另外,芯片的差异化研发需求也难以得到满足。面对天赐良机,一些PCB制造公司正计划扩大ABF板的生产。在中高端封装基板赛道,以兴森科技、深南电路、珠海越亚/越芯半导体,近两年已经开始布局FC-BGA领域,目前正按进度推进,预估2023年第四季应能开始试产。
深南电路是国内封装基板领域先行者,存储类及FC-CSP产品快速突破,积极推进FC-BGA布局,封装基板营收稳步增长。深南电路可以为芯片设计公司、封装测试公司提供2-8层的引线键合工艺基板和倒装封装基板,这些基板主要用于微机电系统,射频模块、存储芯片、基板和应用处理器的封装。
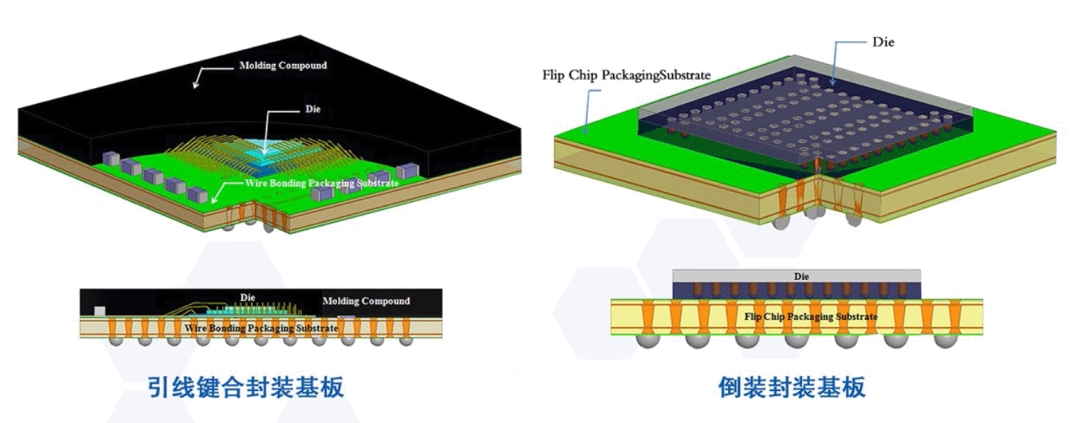
图源:深南电路
深南电路于2021年投入资源对FC-BGA封装基板进行预研,现已具备FC-BGA封装基板中阶产品样品制造能力,目前已有部分产品向客户进行送样验证。高阶产品技术研发按期顺利推进。公司已在2021年开工2亿颗FC-BGA、300万pane LRF/FC-CSP等项目,公司广州封装基板项目规划产品包括使用ABF材料的FC-BGA封装基板产品,项目预计于2023年第四季度连线投产。
兴森科技现已发展为PCB样板、快件和小批量领域的领先者,目前拥有FCBGA(BT)、FCBGA(ABF)两种类型的先进FCBGA封装基板。FCBGA封装基板的应用包括CPU、GPU、FPGA、ASIC等。2023年7月收购日本揖斐电在国内全资子公司北京揖斐电。
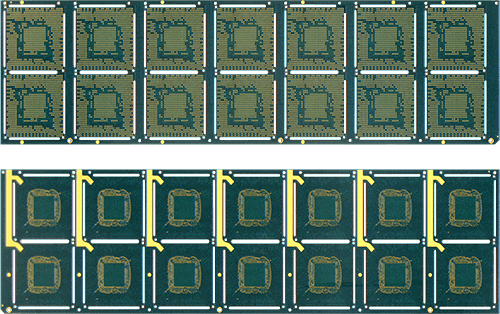 PBGA 图源:兴森科技
PBGA 图源:兴森科技
ABF方面,兴森科技在2022年开工了月产能200万颗FCBGA 项目。珠海FCBGA项目目前处于客户认证阶段,预计第三季度进入小批量试生产阶段。总投资金额预计60亿元的广州2000万颗/月 FCBGA 项目预计2023年第四季度完成产线建设,开始试产。项目一期预计计划2025年达产,达产后产能预计为1000万颗/月;二期预计2027年12月达产,达产后产能预计为1000万颗/月。
越亚半导体是国内首批完成FC-BGA载板导入并顺利投入量产的公司之一。其FC-BGA采用SAP(Semi-additive process)的顺序增层技术生产制造高密度高层数的FCBGA载板,实现倒装芯片的物理承载和高速传输的电信互连。
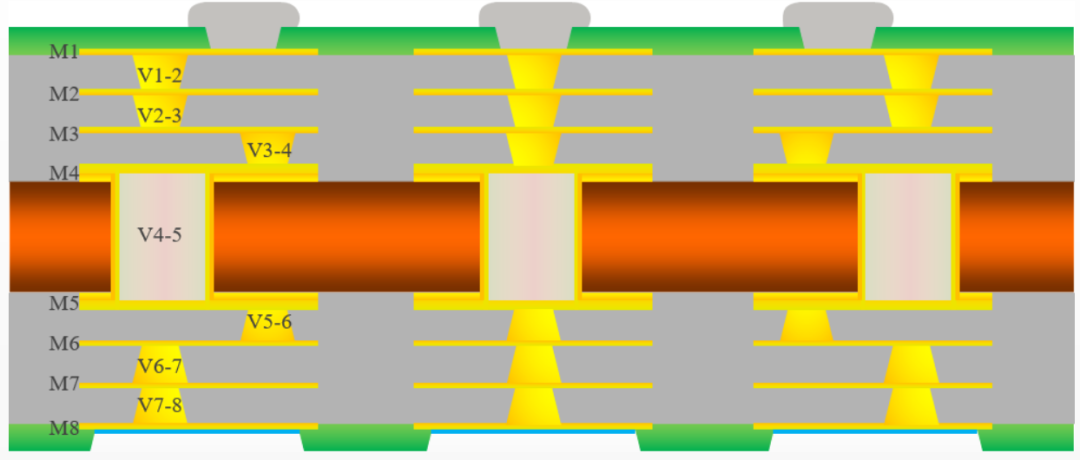
FCBGA封装载板 图源:越亚半导体
早在2012年,越亚半导体就开始布局FCBGA载板的技术储备和关键设备投入。越亚依靠ABF技术研发积累,在2019年完成与ABF载板相关产品终端测试,2021年率先在国内量产FCBGA载板。2021年年底,珠海越亚半导体斥资35亿元建设的“第三工厂”——越芯高端射频及FCBGA封装载板生产制造项目在斗门区开工建设。项目达产后,越亚半导体总计可以提供Via Post铜柱法载板每月12万片以上,嵌埋封装载板每月2万片以上,FCBGA封装载板每月6万片以上的产出;2023年总投资21.5亿元FCBGA封装载板生产制造项目二期项目开工,最终可形成年产FCBGA封装载板约48万片。
以上陆资三强项目将有力弥补国内高端载板的缺口。未来,随着量产跟进仍需将在产品尺寸、层数和密度进一步升级,全村的希望就看这哥仨了。另,还有几位兄弟在打磨ABF新品。
礼鼎半导体专注于高阶半导体封装载板的研发、生产和销售,2023年1月鹏鼎控股向向礼鼎半导体增资1.36亿美元,使其具备了生产制造ABF载板的能力。
科睿斯半导体专注于电子材料研发,2023年刚成立就50亿大手笔签约FCBGA(ABF)高端载板产业项目,打造成国内同行业顶级样板,填补国内该工艺领域空白。2023年7月,劲拓股份拟斥5000万元间接投资科睿斯。

华进半导体是一家半导体封测先导技术研发商,在国内率先实现以ABF为介质的FCBGA基板小批量量产的公司之一,制备出8层大尺寸FCBGA基板。目前相关高阶项目在努力推进。
胜宏科技目前ABF载板仍处于研发阶段,尚未形成收入。
反馈通道:您对文章若有产品信息改进、补充及相关诉求,或有文章投稿、人物采访、领先的技术或产品解决方案,请发送至support@fsemi.tech。





