可用于实验室工艺开发的高性能贴片微组装键合工艺,其应用芯片到热沉基板,芯片到晶圆贴片,微小器件组装、芯片贴合、激光器键合、高端器件组装、高端芯片的封装贴合、各种超高精度微组装、光电二极管、激光巴条键合、特性材料的解键合工艺等各类应用场景,在各个领域发挥了重要了实验研发功能。
功能:
脉冲式下加热平台共晶焊接
点胶、蘸胶(UV胶或固化胶、银浆、各种胶水)
吸嘴加热温度曲线式压焊(金锡、焊片等)
UV紫外光照射固化
倒转芯片金球超声波贴合键合
特点:
闭环式视觉定位系统精度为±0.5um
模块化设计以及高集成度的设备整合度 、根据需要选装特定模块, 适用于各种复杂工艺及场合
基板放置模块以及芯片拾取吸嘴做到尺寸范围内的无需频繁更换
设备的高精度以及高稳定性能可长时间保持
工艺过程实时监控观察,清晰明朗的可视化操作极为简单便捷
倒装贴片应用:
小金球的器件超声波热压≥20um金球直径
金球器件倒装对位键合贴片
超声波的功率大小调节
小锡球的单颗拾取放置≥50um锡球直径
锡球器件倒装对位贴片
上下独立加热系统的执行
主要技术参数:
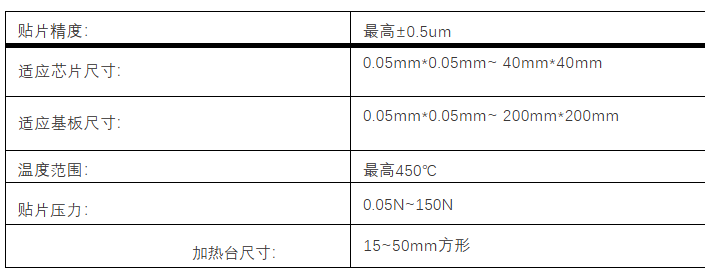
良好的热学性能材料作为加热基底,贴片前的高度及温控压力曲线设定让键合贴片时间及温控得到有效的控制
可进行多种气体的混合使用,例如甲酸、氮氢混合气体的输出,其流量可通过模块控制调节
利用具有自主核心专利技术的高精密光学镜头光束器组件进行精度对准,超过4K的高清显示工业相机组合高清晰的成像效果为高精度贴片提供便捷。




