推动AI高性能计算的先进封装解决方案
目前用于AI云端计算处理器的高密度先进封装,其尺寸至少都是55mm x 55mm以上,其封装基板上的布线层一般至少是5-2-5 (上面5层、中间2层、下面5层),甚至可多达11-2-11。其封装型态一般是使用扇出型技术加上silicon bridge,也可以是2.5D封装,以硅中介层 (Si Interposer) 作为小芯片的整合平台。业界的目标都是在同样的空间中,获得更多算力。
日月光提供的高密度封装的解决方案:包含覆晶球格数组封装 (FCBGA)、Fan Out Chip-on-Substrate (FOCoS)、FOCoS-Bridge以及2.5D封装等三大类。FCBGA芯片间封装互联线的整合是透过BGA基板达成,其最小L/S (线宽/线距) 一般仅能达到10μm/10μm。目前很热门、供不应求的CoWoS (Chip on Wafer on Substrate) 是一种2.5D封装技术,以硅中介层(Si Interposer) 上的重布线层 (RDL) 连接整合小芯片,可以将L/S大幅微缩到0.5μm/0.5μm。由于硅中介层需要承载所有的芯片 (以相肩比邻的方式排列),因此面积越来越大,使得每片12吋晶圆能切割出的硅中介层芯片越来越少 (一般少于五十颗),导致2.5D封装的制造成本也随之大幅上升。但是并非所有应用皆需要0.5μm/0.5μm的L/S,因此日月光发展FOCoS (Fan Out Chip-on-Substrate),利用扇出型技术的RDL来整合不同小芯片,其L/S可以达到2μm/2μm,其优势是以相对较低的制造成本,提供市场不同的解决方案。此外ASE的FOCoS-Bridge技术利用高密度连接线硅桥 (silicon bridge),L/S可以达到0.5μm/0.5μm,在需要高速传输的区域连接不同芯片 (例如逻辑芯片和记忆体),而在其它区域以Fan-Out RDL整合,因此在L/S设计上可以兼具0.5μm/0.5μm + 2μm/2μm的弹性,同时达成封装密度以及带宽的大幅提升。
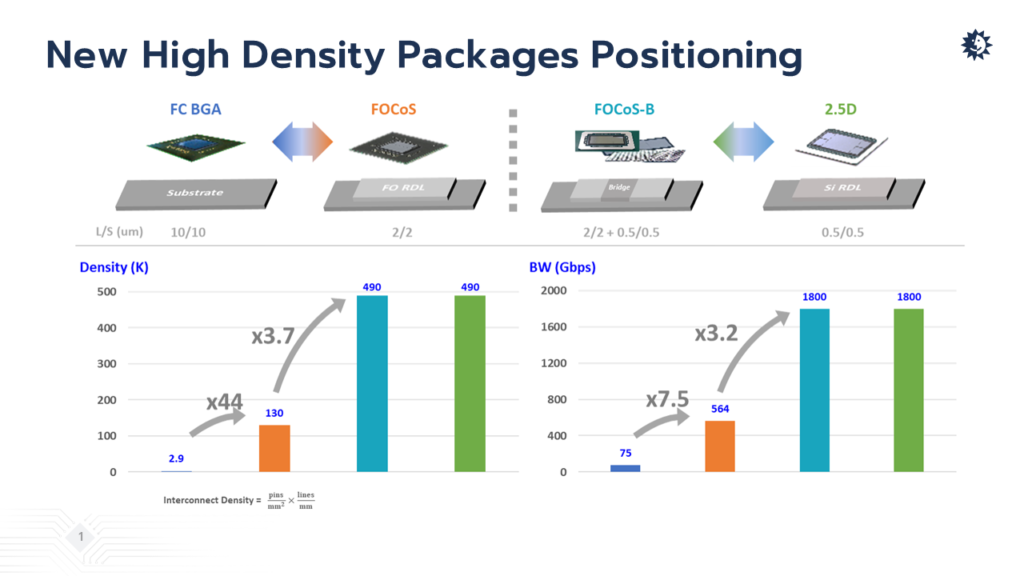
高性能芯片/封装/系统共同设计(Co-Design)
要达成前述的带宽大幅提升,需要由芯片、封装一直到整个系统都要一起考虑,以实现整个系统而不仅是个别元件的Holistic Design最优化。利用电子设计自动化 (EDA) 作设计最优化的时候,需要考虑讯号在整个传输路径上会有多少改变,例如需考虑Cu pillar, RDL fine line, TSV, μbump等,最后利用眼图(eye diagram) 分析 SerDes electrical performance。针对高速讯号差动对线 (differential pairs) 设计的时候,需要降低反射损耗 (return loss) 及插入损耗 (insertion loss),尤其是在工作的频段。日月光的优势在于我们能够做到由芯片、封装到整个系统,从头到尾的完整设计。
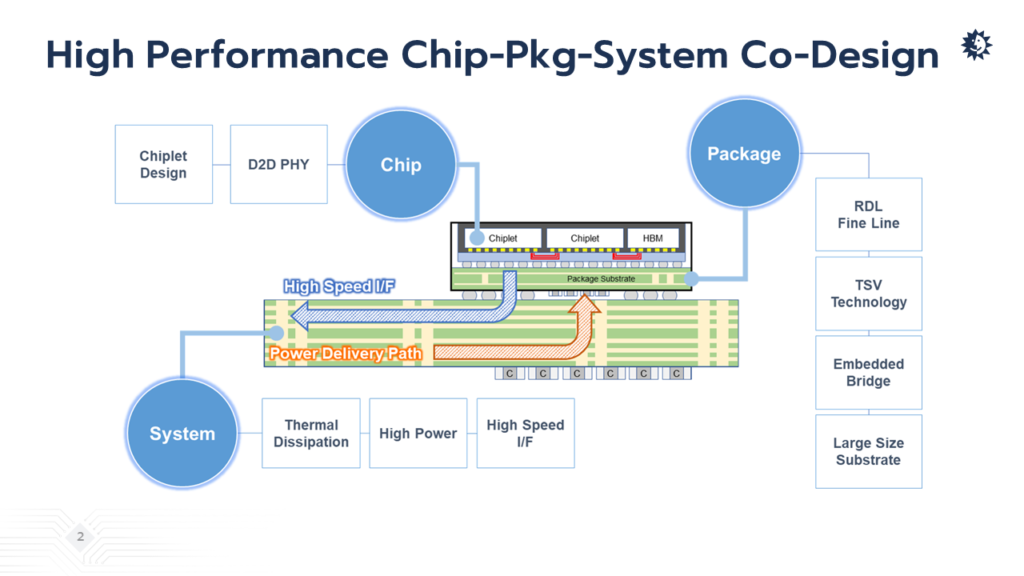
如何节省Power达到更大的每瓦算力
目前业界都在思考一件事情,本来放在系统上的Power组件,能不能放在离Package或Processor芯片越近越好;甚至重新思考设计供电架构,例如直接由芯片背面供电 (Chip Backside Power Delivery)。

电容放对位置可以有效增进电源完整性 (Power integrity),降低电源噪声 (Power Noise),虽然理论上电容离芯片越近越好,但是需要考虑电容的尺寸以及制程,让整体最便宜,效果最好。常见的SMT电容都是蛮大一颗,但现在已经有芯片层级的硅电容 (Si-Cap),也都可以提供不错的电容值。
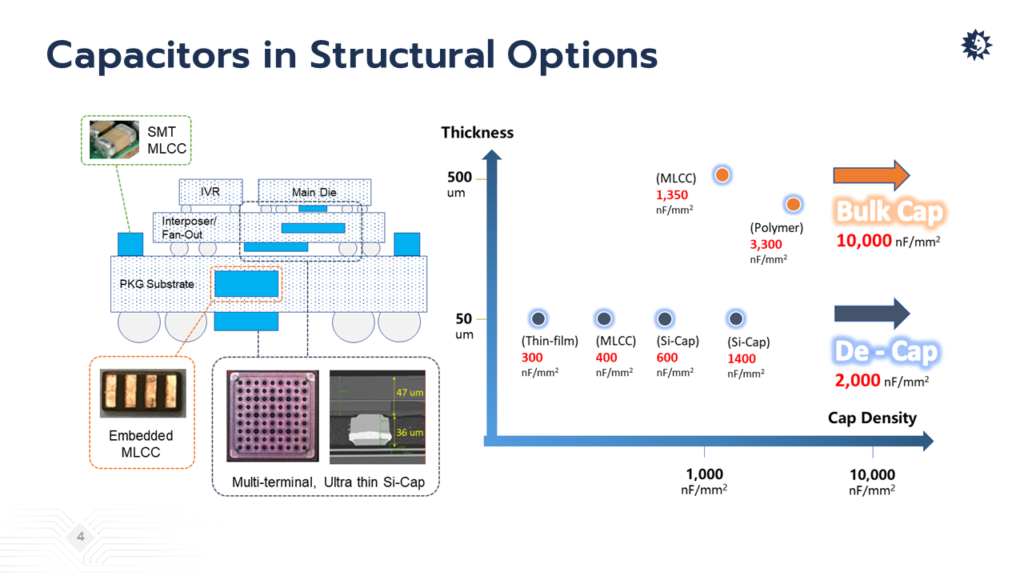
UCIe (Universal Chiplet Interconnect Express) 产业联盟
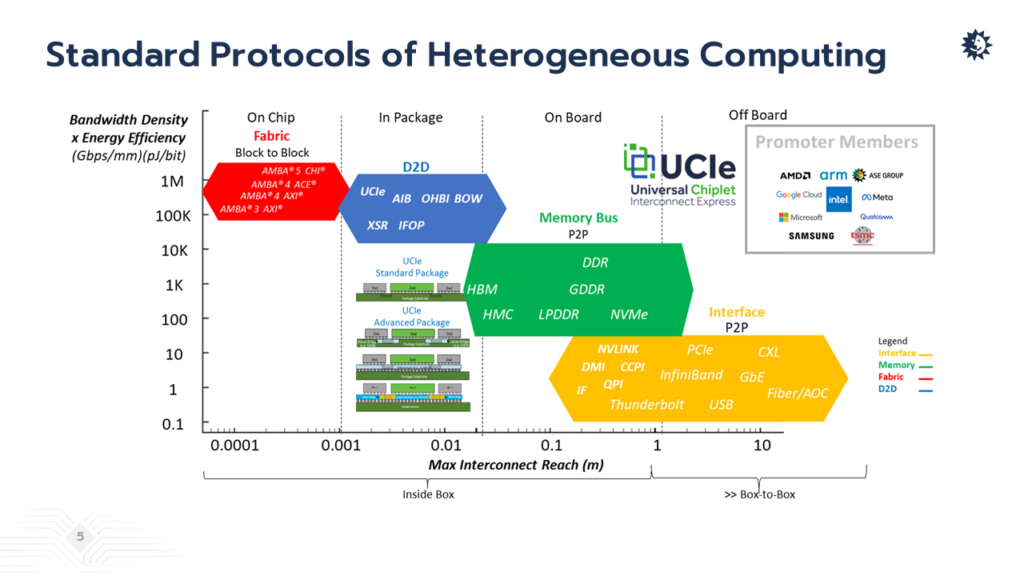
异质整合的概念已经发展多年,不只可以用在异质小芯片间的整合,也可以把其他非芯片的主/被动元件,甚至连接器都整合在单一封装体内。要做到这点,不只需要封装技术,更需要设计跟测试的配合。日月光可以提供从设计、封装到测试的一条龙服务方案,协助客户减少芯片设计时程并加快产品开发速度。




