近日,国内高端半导体设备供应商普莱信正式推出其最新研发的Phoenix 350轻量化TCB热压键合机。该产品专为解决CPO(共封装光学)封装以及WLP(晶圆级封装)工艺中的核心痛点而设计,凭借其超高精度、高速度及多功能的工艺能力,为光电封装领域提供了全新的技术解决方案。

直击CPO封装痛点,TCB技术成关键
随着数据中心、人工智能和高性能计算对带宽和能效要求的不断提升,CPO技术作为解决传统可插拔光模块带宽瓶颈的核心方案,正逐步成为行业焦点。然而,CPO封装过程中面临诸多挑战,尤其是在将光芯片和电芯片进行高密度集成时,对贴片精度、温度控制和力控稳定性提出了极高的要求。传统封装设备难以满足CPO所需的微米级甚至亚微米级对位精度和复杂的键合工艺,导致良率低、生产效率受限。
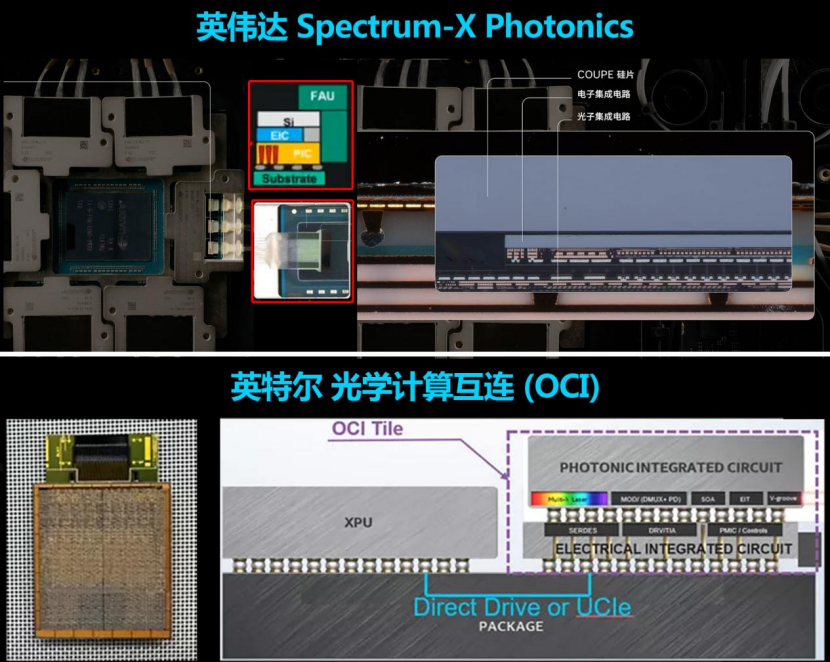
Phoenix 350:专为CPO及WLP工艺量身打造
普莱信此次推出的Phoenix 350轻量化TCB热压键合机,正是针对上述痛点而研发。该设备集成了多项业界领先的技术,超精密、快温变、全域均匀、高真空/气氛可控、高刚性,适配晶圆级批量生产与超细间距,满足WLP及相关堆叠封装需求。为CPO及WLP封装提供了高效、可靠的解决方案。
1. 极致精度,确保光学耦合效率
CPO封装的核心在于确保光信号在芯片间的高效传输,这要求芯片贴装必须达到极高的对位精度。Phoenix 350具备±0.5μm @3σ的贴片精度和±0.01°@3σ的角度控制能力,配备双视觉对准系统,可自动补偿晶圆翘曲、热变形,适配超细间距微凸点,可重复实现的亚微米贴装精度,从根本上保证了光路对准的准确性,有效提升了器件的性能和良率。
2. 高速生产,满足大规模制造需求
Phoenix 350配置了高刚性机架,精密运动轴,低振动,Z轴柔顺控制,避免冲击晶圆与凸点。在保证精度的同时,大幅提升了生产效率和设备产出,满足了CPO技术从实验室走向大规模量产的需求。
3. 灵活的物料与工艺兼容性
面对WLP工艺中多样化的芯片尺寸和物料形式,Phoenix 350展现出极高的灵活性。它支持6个6寸或3个8寸晶圆环,兼容wafer、waffle pack、gel-pak等多种物料装载形式,并可支持各种不同的芯片尺寸和多芯片贴装,支持dipping蘸胶工艺。此外,设备可应对晶圆翘曲、超细间距、薄晶圆、异质集成等WLP专属挑战,保障键合良率与可靠性,同时支持die to die,die to substrate以及die to wafer制程。
4. 精准温控与力控,保障键合质量
TCB工艺对温度和压力的控制要求极为苛刻。Phoenix 350的邦头加热功能可达450℃±2.5℃,具备最高60℃/S的升温和50℃/S的降温能力,配合基板350℃±3.5℃的加热功能,能够快速、稳定地达到工艺窗口要求。同时,其高稳定的力控制系统支持10g到10kg(依据不同配置)的可编程调节力度,力控精度达到2%,可满足超低贴片压力的需求,有效保护脆弱的芯片结构,提升键合可靠性。
5. 多气氛支持与无助焊剂工艺,提升良率
Phoenix 350可兼容氮气、甲酸、氮氢混合气氛,不仅仅支持NCF/NCP/TCCUF还支持Fluxless工艺,有助于获得更洁净的键合界面,有效解决了助焊剂的残留对光器件的污染问题。设备卓越的气密性及极低的气体消耗,进一步优化了工艺成本和环境控制。
6. 智能化与可追溯性
设备搭载了超高清的PLXvision™视觉对位系统,确保了对位的精准和快速。通过SECS/GEM (MES)接口,Phoenix 350兼容多类WLP相关键合工艺,可一体化集成多道工序,适配薄晶圆、异质材料,实现了工艺和材料的全程可追溯性,满足现代智能工厂的管理要求。其高自动化的设计,支持手动及全自动上下料传动系统,并可选的工艺模块实现个性化配置,适应不同客户的产线需求。
普莱信:赋能先进封装未来

普莱信一直致力于为半导体封装领域提供高端装备和技术创新。Phoenix 350轻量化TCB热压键合机的推出,不仅展示了普莱信在亚微米高精度运动控制、热管理及机器视觉等核心技术上的深厚积累,也标志着公司在助力CPO等前沿封装技术产业化落地方面迈出了关键一步。普莱信将继续以客户需求为导向,通过持续的技术创新,为全球半导体及光电子产业提供更多高性能、高可靠的封装解决方案。




