近日,华进半导体联合中科院微电子所和华大九天发布了一项针对2.5D转接板工艺的APDK(Advanced Packaging Design Kit)。该APDK的发布标志着国内先进封装领域的新突破,将成为沟通IC设计和封装厂商的桥梁。
APDK包括四大模块,分别是:
Technology File:底层设置文件,负责定义工艺参数,提供工艺及设计优化指导;
常规结构:针对华进硅转接板制造工艺中的常用结构(包含Via/Micro Bump/C4 Bump/TSV/Testkey等),APDK提供参数化单元,供用户在design rule的约束下灵活选择;
IPD器件与模型:针对集成硅转接板的无源器件,APDK提供了参数化单元以及包含元件电学特性的模型,为用户搭建原理图、前仿真、layout以及后仿真提供可靠支持;
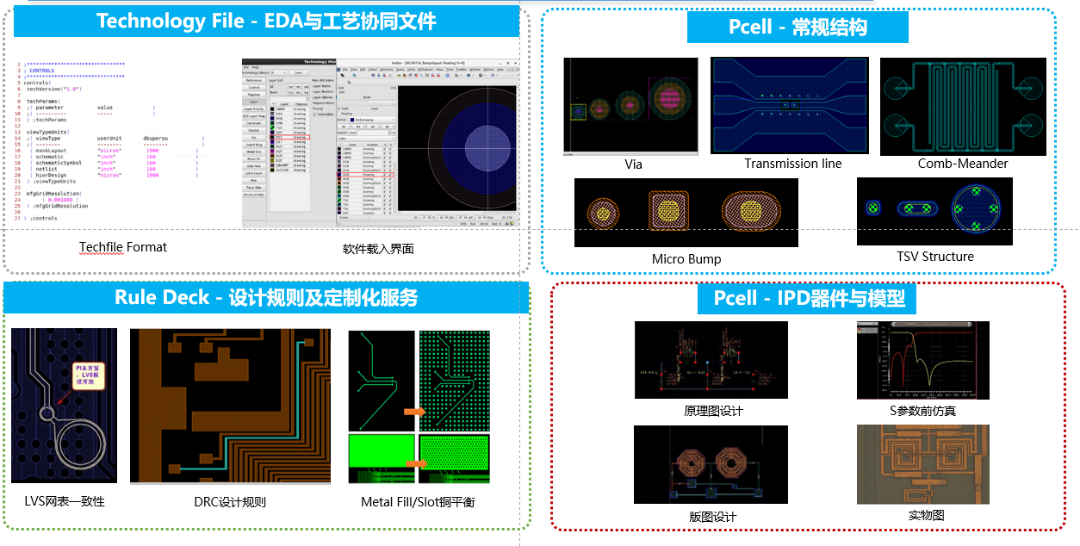
APDK的优势:
搭建华进半导体转接板生产工艺下的各种器件库,如:参数化单元(VIA/TSV/TestKey等),IPD器件SPICE模型;
华进半导体在先进封装领域深耕十年,根据自身工艺能力,建立了一组描述半导体工艺细节的文件,供EDA工具配套使用;
定制化的先进半导体封装设计规则检查方案,以确保设计版图满足华进生产指标。
华进半导体自成立之初便集中精力开发TSV技术,并在国内率先实现了12吋硅通孔转接板的制造;基于此研发成果,华进半导体还重点开发了Via-Last TSV、晶圆级封装等先进工艺,构建了较为完整的三维系统集成封装技术体系。目前,华进半导体有能力提供从2.5D封装设计、到硅转接板晶圆制造、到2.5D组装成套一站式解决方案,并已为国内外50余家知名企业提供了2.5D/3D集成封装技术服务。未来我们将凭借工艺经验,面向Chiplet等前瞻性技术,开发并建立一系列专用APDK,为发展更小线宽线距、更高集成度的先进封装工艺技术打下夯实基础。




